作为芯片制造后道工序的核心环节,晶圆切割(又称划片)是将整片晶圆按芯片尺寸分割成独立芯片的关键工艺。这道工序直接决定了芯片的良率上限、性能表现和制造成本。随着芯片向“更薄(<100μm)、更大尺寸(12英寸)”演进,传统切割方式的局限性日益凸显,以激光技术为代表的新一代切割方案正在重塑行业格局。
一、回溯传统:砂轮切割的黄金时代与先天短板
砂轮切割是目前应为zui广泛的传统切割方式。其原理是采用由金刚石颗粒和粘合剂构成的刀片,经主轴联动高速旋转,以一定速度进给将晶圆逐刀分割成独立芯片。这一技术成本低、适用性广,至今仍在大量产线上服役。

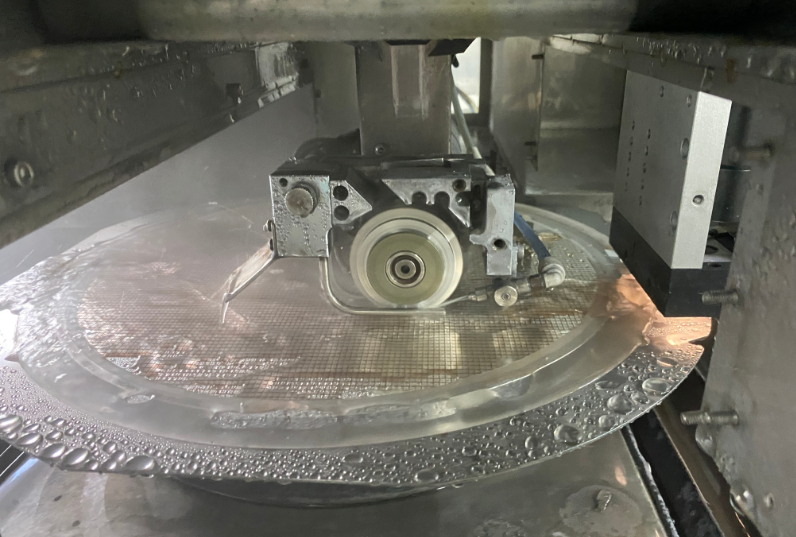
国内主流晶圆切割方式:砂轮切割(图片来源网络)
然而,物理接触式的切割方式存在难以克服的短板:切割过程中产生的残余应力和机械损伤容易导致边缘崩缺、裂纹,甚至隐裂,严重影响良品率和产能效益。对于厚度在100μm以下的超薄晶圆,机械切割极易导致晶圆破碎。此外,砂轮切割的划片间道宽度通常需要80μm,大幅降低了晶圆面积的利用率。传统刀片切割在应对超薄晶圆时,崩边、隐裂、颗粒污染等问题尤为突出,严重影响后续封装良率。
二、技术跃迁:激光切割如何改写游戏规则
激光切割技术的出现,为晶圆加工带来了根本性的变革。目前激光切割主要分为激光烧蚀切割和激光隐形切割两种路径:
①激光烧蚀切割是将激光能量集中于微小区域,使固体材料升华、蒸发,实现全切割或开槽加工。由于是非接触式加工,不会产生崩刃和刀具磨损。但其局限性也较为明显:激光烧蚀在表面会产生碎屑,需要额外的湿法清洗工序,且存在热影响问题,可能对芯片造成热损伤。
②激光隐形切割则代表了更高阶的技术方向。其原理是选用可穿透晶圆的激光,聚焦于晶圆内部而非表面,使内部局部原子结构改变形成“改质层”,再通过扩膜等方式施加外力,使裂纹沿改质层精 准延伸,实现晶圆分离。这一技术路线具有以下核心优势:
切割缝接近为0,隐形切割仅需15μm的划片间道宽度,远小于传统砂轮切割的80μm。对1mm×1mm的芯片,晶圆可产出芯片量增加13.3%;对0.5mm×0.5mm的芯片,可实现晶圆总出芯片量1/4以上的增加。
全程无崩缺、无粉尘产生,彻底杜绝二次污染,加工精度可达<1μm,加工速度高达500mm/s,高效匹配规模化量产需求。


图片来源:AI图片
三、主流技术矩阵:2026年行业标配与进阶方案
综合当前行业实践,常用的晶圆切割方式主要有以下四种:
| 切割技术 | 核心原理 | 典型应用场景 |
| 砂轮切割 | 金刚石砂轮高速磨削 | 通用硅晶圆、成熟工艺制程 |
| 激光烧蚀切割 | 激光高温气化材料 | SiC、GaN等硬脆材料加工 |
| 激光隐形切割 | 内部改质层+外力分离 | 超薄晶圆、MEMS、存储芯片、先进封装 |
| 等离子切割 | 反应性气体蚀刻 | 微小芯片、高端器件、异形芯片 |
砂轮切割凭借成本低、技术成熟的优势,仍是国内应用较为广泛的切割方式,在中低端通用场景中占据主导地位。激光切割机的销售额占比已从初步约5%提升至2021年的38%左右,正在刀片切割较薄弱的领域发挥越来越重要的作用。
激光隐形切割正成为高端芯片加工的核心方案。以SDBG(先隐切后减薄)工艺为代表的技术路线,先利用激光在晶圆内部预设隐形改质层,再进行背面减薄研磨,晶圆在应力作用下自动分离成单芯片,特别适用于厚度35~85μm的超薄晶圆加工。等离子切割作为一种“面加工”技术,一次性处理整个晶圆表面,适合微小芯片和高端器件,加工损伤极小,芯片强度更高。
全球晶圆切割服务市场预计到2025年将达到约6.175亿美元,到2035年将超过9.329亿美元,复合年增长率达4.21%。中国市场晶圆切割液市场规模预计到2032年将达2067百万美元,年复合增长率6.4%(据QYR调研)。
四、配套化学品:决定切割质量的关键一环
无论选择哪种切割技术,配套化学品的性能都直接影响切割效果和良品率。
晶圆切割液是半导体晶圆加工的专用功能性耗材,主要分为油基型和水基型。其集冷却、润滑、悬浮和清洗等核心功能于一体,通过在晶圆表面形成保护膜,降低切割阻力,散发加工过程中产生的热量,并防止边缘崩裂或表面划痕。适用于硅、碳化硅、氮化镓、石英等多种晶圆材料和机械切割、多丝切割等工艺。
晶圆激光切割保护液则是激光切割工艺中的关键辅助材料。其核心作用是在激光加工前涂布于晶圆表面,形成一层耐温的高分子薄膜,防止镭射切割工艺产生的烧出物直接接触或再附着于晶圆表面。含有水溶性树脂、表面活性剂、紫外吸收剂等组份,具有优异的润滑、散热、阻热、冷却功能,可减少热效应,抑制静电,有效防止切割碎屑喷溅到晶圆表面,避免工件裂纹、崩边及表面划伤。
在Low-K切割、晶圆激光全切、晶圆表面激光开槽等工艺中,激光切割保护液可显著提高生产良率,降低切割道崩裂、介电层剥离等品质问题。
五、化学品解决方案,为精密切割保驾护航
如果您正在为晶圆切割工艺中的碎屑回沾、热损伤、崩边等问题困扰,我们的晶圆切割液和晶圆激光切割保护液正是您产线升级的理想选择。
晶圆切割液:水基型配方,具有卓 越的润滑、冷却性能,能快速润湿切割界面,高效排出硅粉颗粒物,降低切割阻力,提升切割效能
激光切割保护液:水溶性高分子溶液,涂布后形成均匀保护膜,有效防止激光加工产生的烧出物附着,降低热影响区,阻隔切割颗粒污染
适用范围广:支持硅、碳化硅、GaAs、蓝宝石等多种基底材料的切割保护
易清洗:切割后可用纯水轻松清洗,无残留,符合洁净室工艺标准
提升良率:有效减少崩边、裂纹、划伤等缺陷,提高产品良率和加工效率
环境友好:对人体与环境友好,符合环保政策对水基产品替代油基产品的趋势要求
亦盛科技提供技术支持与定制化解决方案,欢迎随时联系获取样品测试和技术参数资料。
常见问题解答(FAQ)
Q1:激光切割为什么需要使用保护液?
A:激光切割过程中,高温会使材料气化产生烧出物(碎屑),这些烧出物如果直接接触或再附着于晶圆表面,会造成表面污染、热损伤,甚至破坏芯片表面的金属线路和电路结构。激光切割保护液在晶圆表面形成保护膜,可有效防止烧出物附着,阻隔切割颗粒污染,确保芯片边缘质量,同时减少热影响区(HAZ)的形成。
Q2:晶圆切割液和激光切割保护液可以通用吗?
A:两者用途不同,不能通用。晶圆切割液主要用于机械切割(砂轮切割) 工艺,起到冷却、润滑、悬浮和清洗的作用,在切割过程中持续供应以降低切割阻力和散热。激光切割保护液则专用于激光切割工艺,在加工前一次性涂布于晶圆表面形成保护膜,防止激光加工产生的热损伤和碎屑污染。针对不同的切割工艺和材料特性,应选用对应的专用化学品。
Q3:保护液会影响切割精度吗?
A:不会。优质的保护液涂布后形成的薄膜极薄且均匀,不会对激光聚焦和切割精度产生负面影响。相反,由于保护液具有良好的散热、阻热功能,能有效防止激光热能的过度扩散,避免切割道过大,从而有助于保持切割精度和切口质量。
Q4:水基型切割液相比油基型有什么优势?
A:水基型切割液相较于传统油基型产品,在环保性和清洗便利性方面具有明显优势。随着环保政策趋严,行业正加速推动以水基产品替代油基产品的趋势
。水基切割液易清洗、无残留,对人体和环境更友好,同时保持优异的冷却、润滑性能。
Q5:如何选择适合我产线的切割液/保护液?
A:选择切割化学品时,需综合考虑晶圆材料类型(硅/SiC/GaAs等)、晶圆厚度、切割工艺(砂轮切割/激光切割/激光开槽)、设备参数等因素。建议联系供应商进行工艺评估和样品测试,以匹配zui适合您产线的产品方案。我们提供免费样品测试和技术咨询服务,欢迎随时联系我们。
本文内容基于对相关网络公开资料的梳理与总结,并经由AI工具辅助分析、归纳与编辑而成,旨在提供系统化的信息参考。